科技引领·聚势共赢 | 锐杰微(RMT)与华封(Capcon)在先进封装倒装贴片领域签署战略合作协议

2025年7月9日,锐杰微科技(郑州)有限公司(RMT)与北京华封科技有限公司(Capcon)在郑州成功举行战略合作签约仪式,本次战略合作将充分整合双方在各自专业领域的核心优势,重点聚焦晶圆级封装(WLP)、2.5D/3D封装等先进封装设备的前沿技术领域,开展覆盖技术研发、工艺优化等全方位深度协同创新。基于此战略合作,双方将携手推进晶圆级封装技术的创新研发与产业化合作,共同打造具有竞争力的国产封装装备解决方案,以核心技术打破国外厂商在该领域的技术垄断,夯实核心技术发展基础。同时,将重点构建“需求牵引、技术攻坚、产业验证”三位一体的协同创新体系,打造集“设计可控-材料表征-设备优化-工艺验证-应用闭环”于一体的全流程国产自动化先进封装研发生产平台。这一战略合作开创了国内先进封装领域产业链协同创新的新模式,将加速突破高端芯片倒装焊(Flip Chip)关键工艺核心技术的研发瓶颈,推动相关技术成果快速实现产业化应用。



华封科技副总裁宋涛一行在锐杰微董事长方家恩、研究院院长及核心团队的陪同下,对锐杰微郑州生产基地进行了全面考察。重点参观了倒装焊FCCSP/ FCBGA/ FCMCM智能化生产线,以及集成MES/ ERP/ EAP/ PMS等系统的数字化生产管理平台,以及代表行业前沿技术的2.5D先进封装重组晶圆等系列成果,全面展现了锐杰微在智能制造领域的技术实力。此次战略合作中,双方将充分发挥各自技术专长,重点聚焦两大核心领域:智能装备的国产化突破与半导体封装产线的智能化升级。通过深度协同创新,致力于开发具备高精度、高稳定性的智能制造整体解决方案。





座谈会上,华封科技副总裁宋涛表示:“作为半导体封装设备核心供应商,我们正加速推进国产设备创新,以支撑产业链自主可控和AI/HPC芯片封装升级需求。通过设备迭代与工艺协同优化,预计三年内助力客户突破5um至亚微米级倒装焊技术,目前关键设备已攻克工艺瓶颈,可满足高密度互连与超薄封装要求。我们的设备解决方案深度适配晶圆级封装(WLP)工艺,全面支持2.5D/3D集成、超薄CSP及Chiplet异构集成等先进封装技术,将显著提升客户产品的集成度与能效表现。”方家恩董事长对此表示高度认可,并系统性地介绍了公司在3DIS™技术平台的最新突破:“经过研发团队的持续攻关,目前ISoWoS-S™技术路线已完成商业化验证,在智能制造、智慧城市等多个领域实现规模化应用;ISoWoS-LB™取得重要进展,同时3D-SoWoS™路线的研发也按计划稳步推进,整体技术布局成效显著。”
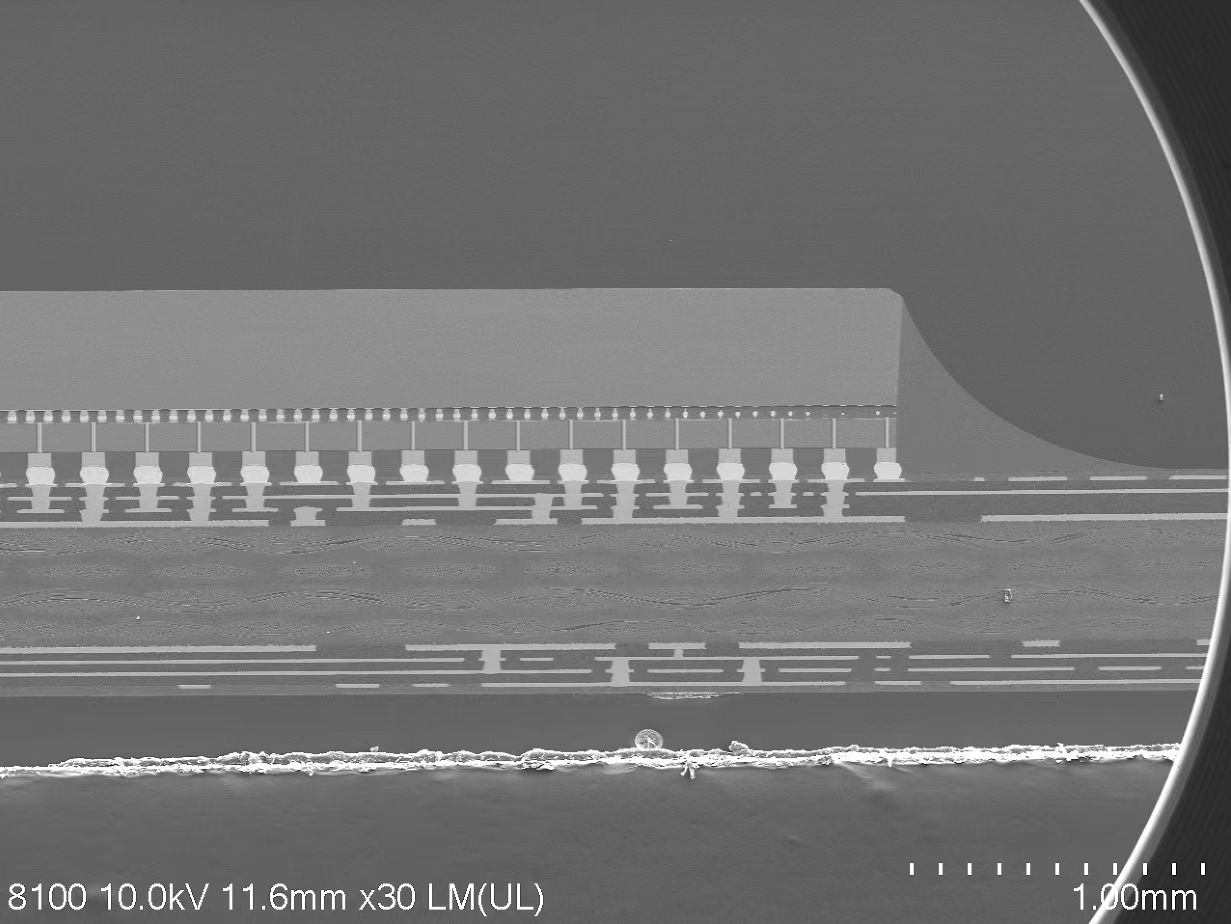
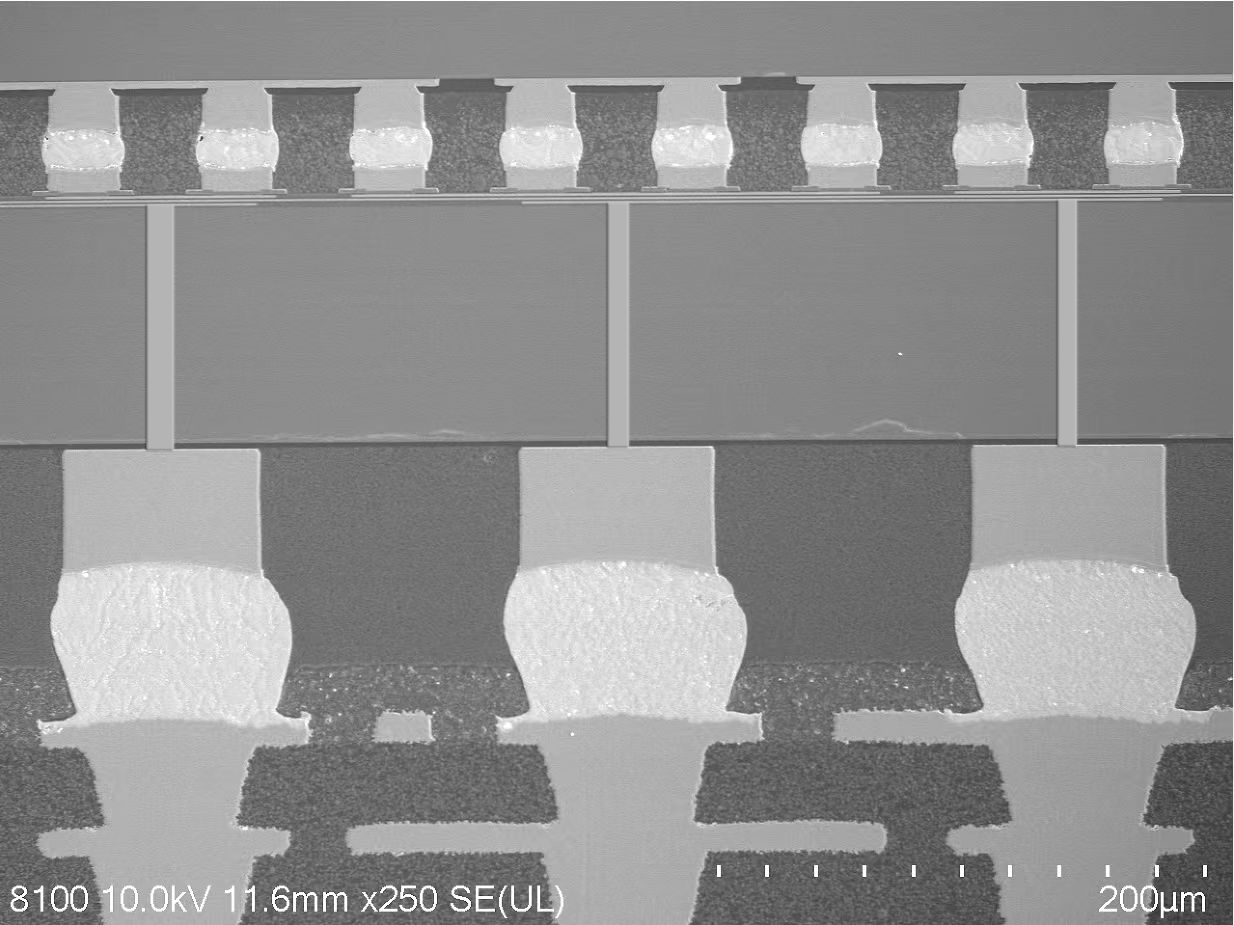
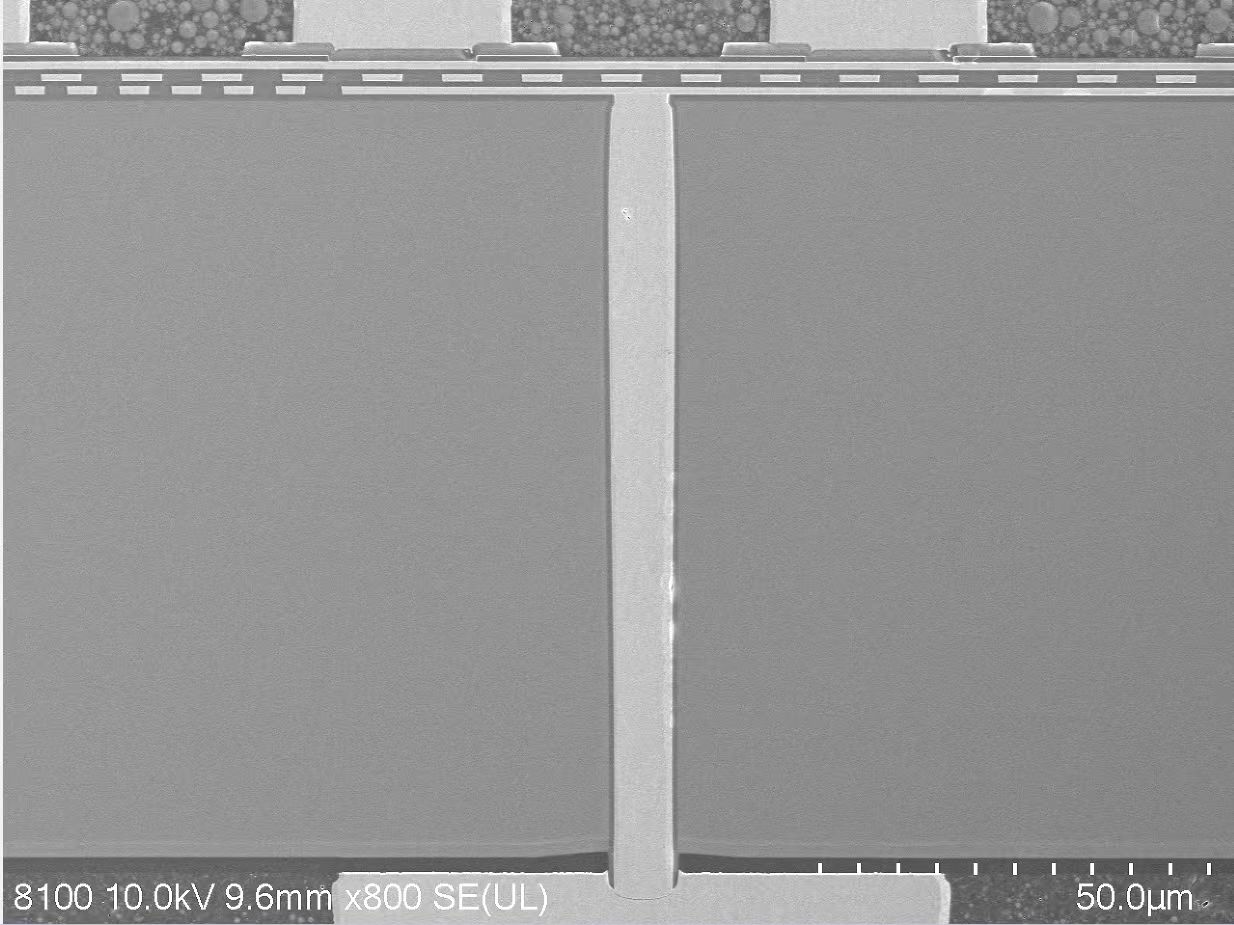
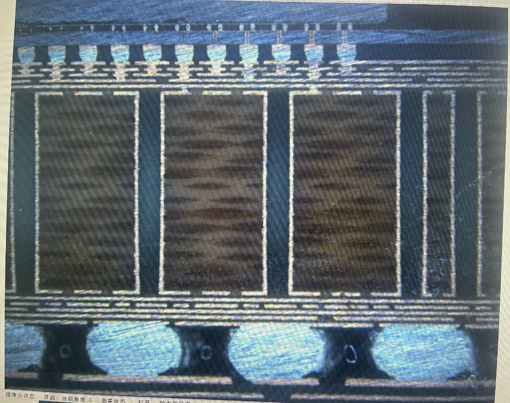
经过深入探讨,双方达成战略共识,将整合各自在工艺研发与装备制造方面的核心优势,为行业提供从设备到工艺的一站式解决方案。此次战略合作的达成,实现了我国在高端封装装备领域从技术引进到自主创新的历史性跨越,为构建安全可控的半导体产业链提供了关键支撑。
